芯片弹坑的形成紧张是由于压焊时输出能量过大,导致芯片压焊区铝垫受损而导致裂纹。弹坑征象在Wire Bonding封装过程中是一个常见的问题,弹坑和Pad失落铝都是在封装过程中压焊芯片时产生的不良征象。
弹坑是由于压焊时输出能量过大,使芯片压焊区铝垫下层Barrier或Oxide受损而留下裂纹;而Pad失落铝则是由于压焊时输出能量过大,使芯片压焊区铝层与阻挡层撕裂分层,导致铝层脱落。

这两种征象都是制造过程中失落效机理之一,其产生的缘故原由紧张包括工艺参数设置不当,形成的缘故原由可能是超声功率、压力、压焊韶光以及温度的设置不当,这些成分都会直接影响压焊质量。
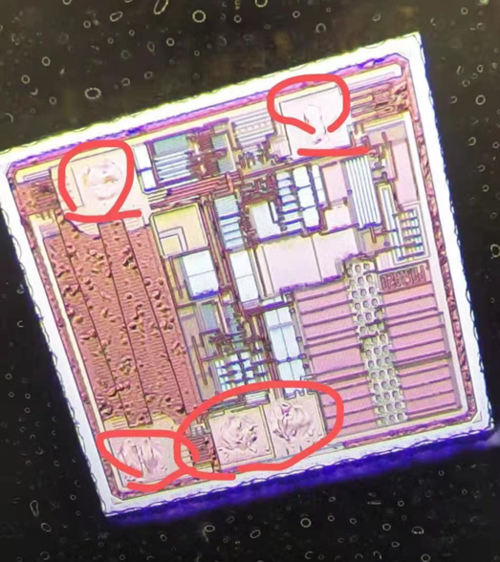
如果压焊前芯片压焊区已被污染,那么压焊的工艺参数就须要根据实际情形重新设置,以担保压焊的键合强度,但这同时也增加了弹坑或失落铝的风险。
弹坑的描述
弹坑的描述多为线型裂纹或弧形裂纹或圆形裂纹。压焊过程利用的劈刀口径为圆形,劈刀安装过程为手工安装,安装过程也会存在安装水平问题,导致键合受力不均,此时键协力度过大时会导致压焊区域呈现一边式的弧形裂纹。安装水平良好时,此时键协力度过大时会导致压焊区域呈现圆形或近似圆形的裂纹。
线型裂纹状弹坑
弧型裂纹状弹坑
圆形描述弹坑
弹坑的风险
01
降落连接可靠性
由于弹坑问题导致的焊线与焊盘之间的连接不良,可能会降落电子元件的可靠性,使产品在利用过程中涌现故障。
而球脱和虚焊可以通过外不雅观检讨、焊线拉力测试和焊球推力比较直不雅观地被创造,而弹坑的检讨方法是须要通过化学的方法去除铝层,在高倍显微镜下检讨弹坑损伤。
02
电阻增加
焊线与焊盘之间的连接不良会导致电阻增加,从而降落电子设备的性能和效率。而弹坑是由于焊球在压到芯片焊区表面时,打仗力、键协力和键合功率设置匹配不当导致焊区的硅层受到损伤。
如果弹坑损伤比较轻微,弹坑一样平常呈月牙型,当弹坑损伤比较严重时,弹坑呈圆环型,当弹坑损伤非常严重时,芯片的硅层表面可以看到通亮的硅缺失落痕迹。
03
导致开路或短路
严重的弹坑问题可能导致焊线与焊盘之间的连接断裂(开路)或者焊线之间的短路,进一步影响产品的性能和稳定性。而弹坑毛病导致芯片硅层损伤每每会导致器件产品的电性不良,紧张表现为泄电非常、 反向击穿电压低。
泄电流非常由于起初比较小,在后续通电利用中不断劣化增大,每每在出厂前无法通过电性能测试完备筛选剔除,当器件产品在客户永劫光通电后,漏 电逐渐增大,进而导致反向击穿电压不断变小,乃至击穿短路,对终端客户的线路功能影响很大。
04
泄电流非常
弹坑会导致芯片在后续的利用中泄电流逐渐增大,这常日在出厂前的电性能测试中无法完备筛选剔除。
05
反向击穿电压降落
弹坑的存在会使芯片的反向击穿电压不断变小,乃至在永劫光利用后发生击穿短路,这对终端客户的线路功能有重大影响。
06
影响产品可靠性和功能性
由于弹坑毛病对器件产品电性能的影响是在后续利用过程中逐渐表示出来的,因此潜伏韶光越长,其造成的连锁丢失也就越大。
来源:季丰电子














