光刻胶作为掩膜材料在半导体加工工艺中起到了图形复制和通报的浸染,而一旦刻蚀工艺(或者其他工艺)完成,光刻胶的义务也就完成,必须将其完备打消干净,这一工序便是去胶。
去胶分为湿法去胶和干法去胶。

1.湿法去胶
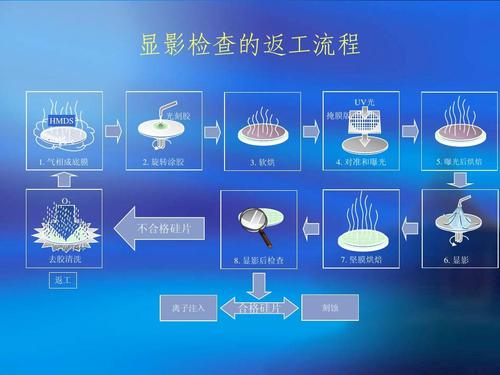
湿法去胶是将带有光刻胶的晶圆片浸泡在适当的有机溶剂中溶解或者分解光刻胶,将晶圆表面的光刻胶去除。在湿法刻蚀前,光刻胶的表面都经由了表面加固处理,这使得光刻胶在大部分去胶液中都不用融或者很难完备溶解。这种情形下,在进行湿法去胶前还须要用等离子体去掉最上面的一层胶。湿法去胶的紧张缺陷是去胶周期长,随意马虎引进无机杂质,并且操作麻烦。
2.干法去胶
干法去胶紧张是等离子去胶,常日采取等离子体氧化或分解等办法去除光刻胶。
等离子去胶机,是广泛运用于去胶的设备。去胶机通过氧原子和光刻胶在等离子体环境中发生反应来去除光刻胶。光刻胶的基本身分是碳氢聚合物,氧原子可以很快地和光刻胶反应天生一氧化碳、二氧化碳和水等,这些天生物会被真空系统抽走。干法去胶既不须要化学试剂,也不须要加温。
干法去胶工艺中必须关注的是由于离子轰击对晶圆片表面器件的损伤。只管目前干法去胶技能已经得到了极大的改进,比如采取顺流去胶机可以大大减少等离子体对器件的损伤,但是随着低介电材料在工业中的广泛运用,技能职员又面临着新的寻衅,他们须要研发新的工艺和设备,使得在工艺生产中不会损伤非常敏感的材料,正是由于这些成分,湿法去胶工艺仍旧被利用。目前,半导系统编制造厂家常日是湿法去胶和干法去胶两种去胶办法一起利用,湿法去胶作为干法去胶的有益补充。















