添加图片注释,不超过 140 字(可选)
半导系统编制造与封装的界线是什么?半导系统编制造与封装的目的不同,半导系统编制造(Front-end)的目标是产生具有繁芜电路图案的裸晶圆,须要在高度掌握的清洁室环境中进行,以防止尘埃影响眇小的电路构造。而封装(Back-End of Line)的目标则是保护裸芯片,增强芯片的物理强度和环境耐受性等。一样平常以晶圆减薄作为制造与封装的分界点,减薄后的晶圆由晶圆厂出货给封装厂,那么半导系统编制造真个工艺结束。不同芯片产品有哪些工艺差异?芯片是一个很宽泛的观点,是一个大类,因此细分为很多种类。一样平常可以分为逻辑芯片(CPU,GPU等),存储芯片(DRAM、NAND ,Flash等),仿照和稠浊旗子暗记芯片,功率器件,射频芯片,传感器芯片等。

添加图片注释,不超过 140 字(可选)
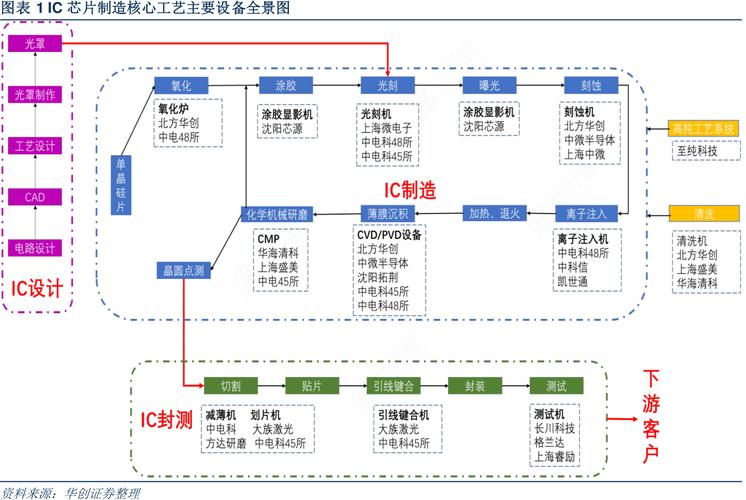
不同类型的芯片产品根据其运用和功能需求,采取不同的设计事理、制程标准和材料选择都不同。比如我们常说的5nm,7nm前辈芯片制程常日是用在逻辑芯片中,而对付射频芯片领域的SAW,BAW等则不以线宽作为考量成分。又比如存储芯片以12寸为主,但是第三代半导体由于SiC基板的限定,普遍采取的是4,6寸。半导系统编制造工艺分类?
光刻
包括涂胶,曝光,显影,烘烤等工艺。
干法
镀膜:包括PVD(物理气相沉积),CVD(化学气相沉积),ALD(原子层沉积)。PVD又包括蒸发(Evaporation),溅射(Sputtering),脉冲激光沉积(PLD)等,CVD包括等离子体增强CVD(PECVD),低压CVD(LPCVD),金属有机CVD(MOCVD),MPCVD,Laser CVD,APCVD,HT-CVD,UHV CVD等
干法刻蚀:干法刻蚀分为物理刻蚀,化学刻蚀,物理化学刻蚀。物理刻蚀包括离子束刻蚀(IBE)等,化学刻蚀包括等离子去胶机等,物理化学刻蚀包括ICP-RIE,CCP-RIE,ECR-RIE,DRIE等。
外延:分为液相外延(LPE),气相外延(VPE),分子束外延(MBE),化学束外延(CBE)等。
离子注入:包括高能离子注入,低能离子注入,高剂量离子注入,高通量离子注入,高质量分子离子注入(High Mass Molecular Ion Implantation)等。
添加图片注释,不超过 140 字(可选)
扩散:气体源扩散,液体源扩散,固体源扩散,预沉积扩散等
添加图片注释,不超过 140 字(可选)
退火:炉管退火,快速热退火,激光退火,等离子体退火等
湿法
湿法分为湿法刻蚀,洗濯,电镀,化学镀,cmp等常见的半导体工艺便是这些,如有兴趣的朋友可以阅读我的其他文章,深入理解半导体行业其它干系知识!
















