集成电路封装技能趋于繁芜化,前辈封装技能成为主流。在集成电路家当 链中,封装处于家傍边下贱,是在对晶圆进行切割后的“包装处理”。IC 进行 封装后,一方面可以提升其坚固程度,另一方面也是为了方便连接PCB 或其他 基板。封装技能是随着芯片技能的发展而发展的,封装技能的利害对芯片质量 有着显著的影响。根据摩尔定律,特色尺寸每3 年缩小1/3,集成度每两年增 加1 倍。因此,集成电路的发展趋势为:尺寸增大;频率提高;发热增大;引 脚变多;芯片封装技能随之发展:小型、薄型化;耐高温;高密度化;高脚位 化,封装技能的变革也带来了封装材料的不断演化。
传统的集成电路(Integrated Circuit,简称IC)封装采取引线框架作为IC 导通线路与支撑IC 的载体,连接引脚于导线框架的两旁或四周,如双侧引 脚扁平封装、四侧引脚扁平封装等。在引脚数量数量还不算太多的时候,此种 封装办法还能够知足哀求。

IC集成度不断提高,封装基板顺势而生。随着半导体技能的发展,IC 的 特色尺寸不断缩小,集成度不断提高,相应的IC 封装向着超多引脚、窄节距、 超小型化方向发展,传统的引线封装已经无法知足。上个世纪90 年代,球栅 阵列封装(Ball Grid Array,简称BGA)、芯片尺寸封装(Chip Scale Package, 简称CSP)等新型IC 高密度封装办法开始涌现,因此IC 载板顺势而生。
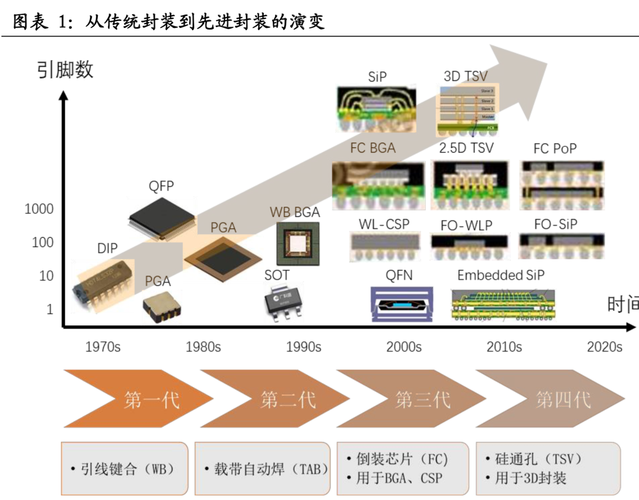
IC封装基板(IC Package Substrate,又称为IC封装载板)是前辈封装用 到的一种关键专用根本材料,在IC 芯片和常规PCB 之间起到供应电气导通的 浸染,同时为芯片供应保护、支撑、散热以及形成标准化的安装尺寸的浸染。 封装基板分类办法较多,紧张可以通过封装工艺、材料性子和运用领域等办法 来分类。
1)按照封装工艺的不同,封装基板可分为引线键合封装基板和倒装封装 基板。
引线键合(WB)封装基板:利用细金属线,利用热、压力、超声波能量为 使金属引线与芯片焊盘、基板焊盘紧密焊合,实现芯片与基板间的电气互连和 芯片间的信息互通,大量运用于射频模块、存储芯片、微机电系统器件封装。
倒装(FC)封装基板:与引线键合不同,其采取焊球连接芯片与基板,即 在芯片的焊盘上形成焊球,然后将芯片翻转贴到对应的基板上,利用加热熔融 的焊球实现芯片与基板焊盘结合,该封装工艺已广泛运用于CPU、GPU 及Chipset 等产品封装。
球形阵列封装(BGA):全称为Ball Grid Airy,其英文缩写BGA,BGA 封装的I/O 端子以圆形或柱状焊点按阵列形式分布在封装下面,多运用于引脚很 多的芯片封装。
芯片级尺寸(CSP):全称为chip scale packaging,属单一晶片的封装, 轻量、小型,其封装尺寸和IC 本身尺寸险些相同或稍大,适用于引脚数不多 的芯片。与BGA 封装比较,同等空间下CSP 封装可以将存储容量提高三倍。
2)按照基板材料的不同,封装基板可以分为硬板、软板和陶瓷基板。
硬板封装载板:以环氧树脂,、BT 树脂,、ABF 树脂作成的刚性有机封装基 板,其产值为IC 载板的大多数。CTE(热膨胀系数)为13~17ppm/°C。
软板封装载板:以PI(聚酰亚胺),PE(聚酯)树脂作成的挠性基材的封 装基板,CTE 为13~27ppm/°C。
陶瓷基板:以氧化铝、氮化铝、碳化硅等陶瓷材料作为的封装基板。CTE 很小,6~8ppm/°C。
3)按照运用领域的不同,封装基板又可分为存储芯片封装基板、微机电 系统封装基板、射频模块封装基板、处理器芯片封装基板和高速通信封装基板 等,紧张运用于移动智能终端、做事/存储等。
1.2.技能壁垒远高于普通PCB,行业玩家少
从HDI 发展而来,技能壁垒远高于HDI 和普通PCB。IC 载板是在HDI 板的 根本上发展而来,两者存在一定的干系性,但是IC 载板的技能门槛要远高于HDI 和普通PCB。IC 载板可以理解为高真个PCB,具有高密度、高精度、高脚 数、高性能、小型化及薄型化等特点,其在多种技能参数上都哀求更高,特殊 是最为核心的线宽/线距参数。以移动产品处理器的芯片封装基板为例,其线宽/线距为20μm/20μm,在未来2-3 年还将不断降落至15μm /15μm,10μm /10μm, 而,而一样平常的PCB 线宽/线距要在50μm/50μm 以上。
与普通PCB 比较,IC 载板存在很多处技能难点,这些技能难点是IC 载板 最大的行业准入门槛,下面总结几点IC 载板的技能难点。
1)芯板制作技能。IC 载板的芯板很薄,极易变形,只有当板件涨缩、层 压参数等工艺技能取得打破之后,才能实现超薄芯板翘曲和压合厚度的有效控 制。
2)微孔技能。微孔孔径一样平常要达到30μm 旁边,远小于普通PCB 和HDI 的微孔孔径,叠孔层数达到3 阶、4 阶、5 阶。
3)图形形成和镀铜技能。镀铜厚度均匀性哀求高,对风雅电路的闪蚀要 求高。目前线宽间距哀求是10-30μm。镀铜厚度均匀性哀求为18±3 微米,蚀 刻均匀性为≥90%。
4)阻焊工艺。IC 载板阻焊表面高度差小于10μm,阻焊和焊盘的表面高 度差不超过15μm。
5)检测能力和产品可靠性测试技能。IC 载板工厂须要配备一批与传统PCB 厂不同的检测设备/仪器,还须要节制与常规不同的可靠性检测技能。
目前IC 载板和PCB 的制作工艺紧张有三种,分别是减成法、加成法(SAP) 与改良型半加成法(MSAP)。
减成法:最传统的PCB 制造工艺,首先在覆铜板上镀一定厚度的铜层,然 后利用干膜将线路及导通孔保护起来,将不须要的铜皮蚀刻掉。该方法最大的 问题是在刻蚀过程中,铜层侧面也会变刻蚀一部分(侧蚀)。侧蚀的存在使得PCB 的最小线宽/间距只能大于50μm(2mil),从而只能用于普通的PCB 和HDI 等产品上。
加成法(SAP):首先在含光敏催化剂的绝缘基板上进行线路曝光,然后在 曝光后的线路上进行选择性化学沉铜,从而得到完全的PCB。该方法由于不需 要后期的蚀刻,可以达到很高的精度,制成可以达到20μm 以下。目前该方法 对基材和工艺流程哀求很高,本钱高企,产量不大。
改良型半加成法(MSAP):首先在覆铜板上电镀薄铜层,然后将不须要电 镀的区域保护起来,再次进行电镀并涂上抗蚀图层,接下来通过闪蚀将多余的 化学铜层去除,留下来的便是须要的铜层线路。由于一开始电镀的铜层很薄, 闪蚀的韶光很短,因此侧蚀造成的影响就很小。比较于减成法和加成法,MSAP 工艺在制造精度与SAP 相差不大的情形下,生产良率大幅提高,生产本钱明显 低落,是目前风雅线路载板最主流的制造方法。
IC载板生产流程繁芜,MSAP 工艺是主流。IC 载板最小线宽/间距普遍要小 于30μm,传统的减成法工艺已经难以知足IC 载板的哀求,MSAP 是目前IC 载 板制造的最普遍工艺。MSAP 工艺除了在IC 载板制造上得到广泛运用之外,苹 果还将该工艺引入了SLP(类载板)的生产制造。目前的设计是稠浊利用减成 蚀刻法和MSAP 工艺,MSAP 工艺能够运用于更薄、更小的母板设计。SLP 的制 成介于高阶HDI 和IC 载板之间,而IC 载板厂商具备明显的技能上风,能够较 为随意马虎的进入SLP 领域。随着消费电子集成度的持续提升,SLP 将会被越来越 多的厂商采取,虽然盈利能力不如IC 载板,但是市场空间可不雅观。
IC载板行业壁垒高,不仅限于技能门槛。极高的技能哀求和浩瀚的专利限 制已经造就了IC 载板行业的高门槛,而该行业的壁垒还包括资金和客户等多 方面。
1)资金壁垒
由于IC 载板具有极高的技能壁垒,前期的研发投入巨大,且耗时良久, 项目的开拓风险大。IC载板产线的培植和后续的运营也须要巨大的资金投入, 个中设备的资金投入最大。IC 载板产线设备浩瀚,单台设备价格可能就会超过1000 万元,设备/仪器投资占IC载板项目总投资60%以上,这对付传统PCB 厂 商而言是个沉重的包袱。以兴森科技为例,公司于2012 开展IC 载板项目,项 目总投资超过4 亿元,估量三年达产,达产后年产值约5 亿元,然而公司IC 载板项目前期开展困难,多年来亏损超4 亿元,严重拖累了公司古迹,直到六 年后的2018 年才逐渐好转。
2)客户壁垒
IC 载板客户验证体系较PCB 更为严格,其关系到芯片与PCB 的连接质量。 行业内一样平常采取“合格供应商认证制度”,哀求供应商有健全的运营网络,高 效的信息化管理系统,丰富的行业履历和良好的品牌荣誉,且须要通过严格的 认证程序,认证过程繁芜且周期较长。还是以兴森科技为例,经由近两年的验 证互助,公司才于2018 年9 月通过三星认证,并且大规模为三星供货还需一 段韶光。
3)环保壁垒
与PCB 类似,IC 载板的生产制造过程涉及多种化学和电化学反应,生产的 材料中也包含铜、镍金、银等重金属,存在一定的环保风险。随着国家对环保 重视力度的加大和环保政策的持续出台,IC 载板项目的前期环评愈发困难,环 保的趋严也进一步提升了行业资金门槛,资金实力不足雄厚的企业难以拿到行 业准入门票。
1.3.上游材料核心是基板,下贱运用广泛
封装基板是 IC 封装最大的本钱,占比超过30%。IC封装本钱包括封装基 板、包装材料、设备贬值和测试等,个中IC 载板本钱占比超过30%,是集成电 路封装的本钱大头,在集成电路封装中霸占主要的地位。对付IC 载板来说, 其基板材料包括铜箔、基板、干膜(固态光阻剂)、湿膜(液态光阻剂)及金 属材料(铜球、镍珠及金盐),个中基板占比要超过30%,是IC载板最大的成 本端。
1)紧张原材料之一:铜箔
与PCB 类似,IC 载板所需铜箔也为电解铜箔,且需是超薄均匀性铜箔,厚 度最低可达1.5μm,一样平常为9-25μm,而传统PCB 所用铜箔厚度为18、35μm 旁边。超薄均匀性铜箔的价格要高于普通电解铜箔,在加工难度上也要更大一 些。
2)紧张原材料之二:基板
IC 载板的基板类似于PCB 的覆铜板,紧张分为硬质基板、柔性薄膜基板和 共烧陶瓷基板三大种类,个中硬质基板和柔性基板具备更大的发展空间,而共烧陶瓷基板发展趋于减缓。IC 载板基材紧张考虑的成分包括尺寸稳定性、高频 特性、耐热性和热传导性等多种哀求,目前硬质封装基板紧张有三种材料,分 别是BT 材料、ABF 材料和MIS 材料;柔性封装基板基板材料紧张包括PI(聚 酰亚胺)和PE(聚酯)树脂;陶瓷封装基板材料紧张为氧化铝、氮化铝、碳化 硅等陶瓷材料。
硬质基板材料:BT、ABF、MIS
1、BT 树脂
BT 树脂全称为“双马来酰亚胺三嗪树脂”,由日本三菱瓦斯公司研发,虽
然BT 树脂专利期已过,但三菱瓦斯公司在BT 树脂研发和运用方面仍处于环球 领先地位。BT 树脂具备高Tg、高耐热性、抗湿性、低介电常数(Dk)和低散 失落成分(Df)等多种上风,但是由于具有玻纤纱层,较ABF 材质的FC 基板更 硬,且布线较麻烦,雷射钻孔的难度较高,无法知足细线路哀求,但可以稳定 尺寸,防止热胀冷缩而影响线路良率,因此BT 材质多用于对付可靠度哀求较 高的网路晶片及可程式逻辑晶片。目前,BT 基板多用于手机MEMS 芯片、通信 芯片和内存芯片等产品,随着LED 芯片的快速发展,BT 基板在LED 芯片封装上 的运用也在快速发展。
2、ABF
ABF 材料是由Intel 主导研发的材料,用于导入Flip Chip 等高阶载板的 生产。比较于BT 基材,ABF 材质可做线路较细、适宜高脚数高传输的IC,多 用于CPU、GPU 和晶片组等大型高端芯片。ABF 作为增层材料,铜箔基板上面直 接附着ABF 就可以作线路,也不须要热压合过程。过去,ABFFC 有厚度上的问 题,不过由于铜箔基板的技能越来越前辈,ABFFC 只要采取薄板,就可以办理 厚度的问题。早期ABF 载板运用在电脑、游戏机的CPU 居多,随着聪慧型手机 崛起和封装技能改变,ABF 家当曾陷入低潮,但在近年网路速率提升与技能突 破,高效能运算新运用浮上台面,ABF 需求再次放大。从家当的趋势来看,ABF 基材可以跟上半导体前辈制程的脚步,达到细线路、细线宽/线距的哀求,未 来市场发展潜力可期。
产能受限,行业龙头开始扩产。2019 年5 月,欣兴宣告,估量自2019 年 至2022 年投资200 亿元来扩增高阶IC 覆晶载板厂,大力发展ABF 基板。其他 台厂方面,景硕估量将类载板转往生产ABF,南电也在持续增加产能。
3、MIS
MIS 基板封装技能是一种新型技能,目前在仿照、功率IC、及数字货币等 市场领域迅速发展。MIS 与传统的基板不同,包含一层或多层预包封构造,每 一层都通过电镀铜来进行互连,以供应在封装过程中的电性连接。MIS 可以替 代一些传统的如QFN 封装或基于引线框的封装,由于MIS 具有更细的布线能力, 更优的电和热性能,和更小的形状。
柔性基板材料:PI、PE
PI、PE 树脂在挠性 PCB 和 IC 载板中得到了广泛的利用,尤其在带式 IC 载 板中运用最多。挠性薄膜基板紧张分为三层有胶基板和二层无胶基板。三层有 胶板最初紧张用于运载火箭、巡航导弹、空间卫星等军工电子产品,后来也扩 展到各种民用电子产品芯片;无胶板厚度更小,适宜于高密度布线,在耐热性、 细线化和薄型化具有明显的上风,产品广泛运用于消费电子、汽车电子等领域,是未来挠性封装基板紧张发展方向。
上游基板材料生产厂商较多,海内技能相对薄弱。IC 载板核心材料基板种 类较多,上游生产厂商多为外资企业。以利用量最大的BT 材料和ABF 材料为 例,环球BT 树脂紧张生产厂商为日企三菱瓦斯化学和日立化成,中国紧张是 台湾地区产能较大,包括景硕、欣兴和南电等,大陆企业涉及的很少;ABF 材 料龙头包括南电、Ibiden、Shinko、Semco 等,欣兴正积极赶进度,中国大陆 内资企业少有涉及。就中国企业而言,生益科技走在了IC 载板基材研发生产 前列。公司于2018 年5 月发布公告称,对“年产1,700 万平方米覆铜板及2,200 万米商品粘结片培植项目”进行变更,原项目履行地点地块将方案培植封装载 板用基板材料生产线。公司在IC 载板基材真个布局有望打破外资巨子的技能 包围,加速PCB 和IC 载板的国产替代进程。
IC 载板运用领域广泛。主流封装基板产品大致分为五类,分别为存储芯片 封装基板、微机电系统封装基板、射频模块封装基板、处理器芯片封装基板和 高速通信封装基板,这些芯片由于集成度高,基本都已经采取基板封装方案, 随着IC 集成度的不断提升,其他芯片采取IC 载板的的比例也会越来越高。
2.日韩等三足鼎立,市场集中度高2.1. 从日本开始,发展至日韩等三足鼎立
行业格局为日韩台三足鼎立,内资企业实力弱。IC 载板技能起源于日本, 后来韩国和中国台湾相继崛起,终极行业格局变为日韩台三足鼎立,近年中国 大陆企业有崛起趋势。从20 世纪80 年代末IC 载板被研发出来至今,环球IC 载板发展大致可以分为三个阶段:
第一阶段:1980s-20 世纪90 年代末
此阶段为IC 载板发展初期,由于日本是IC 载板技能的首创者,日本此时 的IC 载板技能环球领先。日本紧张产品为有机树脂封装基板(以BT 基板为主), 霸占环球绝大部分的市场。日本由此出身了多家行业领先的IC 载板企业,包 括Ibidegn、Shinko 和Eastern 等。
第二阶段:20 世纪90 年代末-21 世纪初
随着《美日半导体协议》的签署,处于浪潮之巅的日本半导体芯片家当掉 头滑向深渊。日本的半导体存储家当从环球市占率第一贯接降到忽略不计,而 与此同时,韩国和中国台湾彻底抱上美国大腿,日本半导体家当基本出局。在 这种时期背景下,辅以韩国和中国台湾的人工本钱上风,这两个地区的IC 载 板行业开始崛起,到21 世纪初,环球IC 载板行业基本形成了日韩台“三足鼎 立”的格局。韩国和台湾也相继涌现优质的IC 载板企业,比如韩国的三星机 电和台湾的欣兴电子、景硕科技等。
第三阶段:21 世纪初—至今
行业格局奠定之后,行业内紧张是技能的演进分解。在此阶段,更高技能 水平的MCP(多芯片封装)和SiP(系统封装)用CSP 封装基板得到较大发展,这 个台湾、韩国占居了PBGA 封装基板的大部分市场,日本霸占了倒芯片安装的BGA、PGA 型封装基板的一半多市场。近年来,由于中国玩家的逐渐入局,IC 载板市场格局又开始有所变动。
目前环球封装基板企业集中于日韩台地区,日本IC 载板龙头包括揖斐电、 新光电气和京瓷,三者创立韶光远早于其他地区企业,目前日本霸占了FCBGA、FCCSP、埋入式基板等高端市场,客户多为三星、苹果和Intel 这种行业巨子。 韩国和中国台湾的情形比较类似,两者发达的半导体家当催生了巨大的内需(韩国存储家当发达,台湾晶圆代工家当发达),因此均与本地家当链有密切 联系。韩国拥有三星电机、信泰、大德和伊诺特等IC 载板企业,中国台湾拥 有欣兴电子、景硕、日月光材料和南亚等企业,两个地区的载板产品从低端到 高端具有所覆盖,客户种类也很全面。
从各厂家生产的产品来看的话,有些厂商生产的IC 载板产品种类完好, 而有些厂商专注于生产特定领域的基板。大多数公司生产的都是FCBGA、FCCSP 这些主流基板,而有些实力强大的企业还会涉及引线键合基板、COF、COP 等, 比如欣兴电子和景硕科技等,还有些企业专注于某一种类型基板,比如我国珠 海越亚的RF Module 基板表现突出。
2.2.市场集中度高,大陆发展潜力大
环球排名前十企业产值占比超80%,内资企业不见踪影。根据Prismark 数据,2017 年环球前十大IC 载板企业总产值占比达到83%,行业集中度极高。 个中欣兴电子产值占比达到14.8%,环球排名第一,排名前列的还有IBIDEN、 三星电机、景硕和南亚等企业,而大陆企业在榜单中难觅踪影。
从环球IC 载板龙头企业的主营业务来看,从PCB 业务发展而来的占绝大 多数。目前,从环球IC 载板企业类型来看,紧张可以分为三种:
1)由PCB 企业发展而来。由于封装基板是从高阶HDI 板发展而来,两者 在制造工艺上有共通支出,因此很多PCB 厂商能在此根本上延伸发展出IC 载 板业务。从Prismark 统计数据来看的话,目前绝大多数IC 载板企业都是由这种办法发展而来,比如我国台湾的欣兴电子(联电下属企业)、南亚和华通电 脑等,大陆地区的深南电路和兴森科技也属于这个范畴。
2)由封装厂发展而来。IC 载板也属于封装材料的一种,封装厂为了降落 本钱和吸引客户,也会向上游发展,比较具有代表性的有日月光材料(日月光 集团旗下企业)和全懋精密(硅品科技公司投资)等。
3)纯挚的IC 载板企业。IC 载板门槛高,还拥有巨大的发展潜力,因此就 有一些大型企业设立了基板子公司,比如从属于华硕集团的景硕科技和我国的 珠海越亚(北大方正集团旗下公司)等。
内资IC 载板企业市占率低,奋起直追正当时。中国大陆IC 载板市场企业 数量不算少,台企占绝大多数,欣兴电子、景硕科技和南亚电路等台企在大陆 都有设厂。就内资企业而言,大体上有四家,分别是深南电路、兴森科技、珠 海越亚和丹邦科技,这些企业涉足IC 载板的韶光基本上都是2005 年之后,在 全体IC 载板行业属于“后起之秀”。虽然我国封装基板行业起步晚,但是受益 于环球PCB 产能的中移和中国半导体封测及电子制造业的崛起,行业发展正处 于加速阶段,未来发展潜力很大。
3.行业发展形式明朗,国产替代潜力大3.1.从环球来看:芯片尺寸的提升带来行业持续增长
环球PCB 行业稳定增长,IC 载板占比快速提升。Prismark 数据显示,2018 年环球PCB 产值约为623.96 亿美元,同比增长6%,2017-2022 年环球PCB 产 值复合增长率约为3.2%,全体PCB 行业近年来坚持稳定增长。从产品构造来看, 多层板占比始终坚持在35%以上,仍霸占主流地位,近两年增长最为迅速的是IC 载板。IC 载板在2017 年之前的占比比较稳定乃至稍有低落,但是从2017 年开始迅速提升,占比从2016 年的12.12%提升至2018 年的20%,提升了近8 个百分点,份额提升的缘故原由包括汽车电子和个人终端等领域需求的提升,但更 紧张是受内存芯片景气周期的影响。
IC载板占PCB 市场份额达到12%,个人设备占比最高。根据Prismark 数 据,2018 年IC 下贱市场规模占比最高的仍为移动终端和个人电脑,占比分别 达到26%、21%。在电子设备持续向更轻、更薄追求的趋势下,单个电子设备(尤 其是个人设备)采取的IC 载板数量也在持续提升,未来移动终真个IC 载板市 场规模有望持续提升。
自2016 年探底后,环球IC 载板市场规模稳定增长。由于IC 载板具有半 导体属性,以是其受半导体行业景气度影响,具备一定的周期性。IC 载板的市 场规模从2011 年开始低落,一贯降落至2016 年最低点(65 亿美元)后开始逐 渐回升,根据ASIACHEM 数据,2018 年IC 载板市场规模达到了约74 亿美元, 估量2022 年将打破100 亿美元,5 年CAGR 近8%,远超环球PCB 市场增速。
封装技能不断演进,芯片面积与封装面积比例越来越靠近1。随着集成电 路的迅速发展,IC 封装技能也在不断演进。封装大致发展进程:TO→DIP→PLCC →QFP→PGA→BGA→CSP→MCM,个中较为前辈的CSP 封装技能可以让芯片面积 与封装面积之比超过1:1.14,未来芯片面积与封装面积比例肯定会越来越靠近1,因此未来封装基板面积的增长将紧张来自于芯片面积的增长。
摩尔定律逐渐失落效,芯片尺寸提升是大势所趋。在过去的十几年韶光里, 集成电路内晶体管数量从几千万到几亿,再到如今的近百亿个,芯片的性能每 年都突飞年夜进。得益于摩尔定律的存在,虽然芯片集中度越来越高,但是芯片 的尺寸却越来越小,目前7nm 芯片已经进入量产阶段,5nm 也开始试产。然而 近年来摩尔定律正逐渐失落效,芯片制成的提升已经进入瓶颈,未来3nm 工艺可 能便是现有工艺下的极限。在这种状况下,芯片性能的提升将越来越依赖于芯 片体积的提升。
出于对本钱的考虑,芯片Die 的尺寸不能提升太多,因此CPU 性能的提升 可以通过堆积Die 个数来完成。以AMD 最新最高真个CPU-EPYC 为例,EPYC 采 取一个Package 封装4 个独立Die 的做法,从而实现了单CPU 拥有64 核心128 线程的目标。该做法最大的影响是CPU 的封装面积明显增大,EPYC 尺寸可与成 年人巴掌比较,其IC 载板面积是普通CPU 的4 倍还多。我们认为,随着线程 提升瓶颈的涌现,消费者对更高性能芯片的需求势必将刺激芯片封装尺寸的增 大,而此种趋势将显著提升IC 载板的用料,未来IC 载板市场的需求将随着芯 片尺寸的提升而不断增长。
3.2.从中国来看:国产替代+内资晶圆厂培植推动行业发展
环球半导体市场规模快速增长,中国已经是环球最大的市场。2018 年,全 球半导体市场发卖总额达到4700 亿美元,较2017 年同频年夜增14%;中国大陆 半导体市场发卖总额达到近1600 亿美元,是环球最大的半导体发卖单一市场, 占比近三分之一。
我国半导体家当逆差持续扩大,国产化刻不容缓。虽然我国已经是环球第 一大半导体市场,但是2018 年我国集成电路家当入口总额达到3120.58 亿美 元,贸易逆差达到2274.22 亿美元,占环球集成电路市场总额近一半。我国集 成电路入口额超2000亿美元已有6 年,对付内资企业而言,无论是从家国情 怀,还是从贩子逐利而言,这都是一个巨大的市场,随着国际形势的变化多端, 我国半导体家当的国产化已经是刻不容缓。
IC 载板是半导体家当主要基材,家当转移可类比PCB 行业。根据Prismark 数据,2000 年我国PCB 产值环球占比只有8%,而2018 年我国PCB 产值占比达 到了52.4%,产值规模在环球遥遥领先,是环球最大的PCB 出产国。受益于全 球PCB 产能的中移,中国出身了深南电路、沪电股份等PCB 巨子,还出身了生 益科技这种行业上游材料巨子。我们认为,IC 载板可以看做是高真个PCB 产品, 一旦技能壁垒被内资企业冲破,必将复制PCB 的家当转移历史。同时,IC 载板 是前辈集成电路封装的主要基材,是中国集成电路国产化的主要一环,其国产 化是一定且必须的,我国也必将出身环球IC 载板巨子。
中国IC 载板市场规模近300 亿,内资企业占比低。由于中国IC载板市场 规模没有可靠的公开数据,本文以中国PCB 产值在环球占比乘以环球IC 载板 市场规模,得出大致的中国IC 载板市场规模(2018 年我国IC 载板市场规模约 为260 亿元)。2018 年,A 股上市公司深南电路和兴森科技的IC 载板业务营收 之和为11.83 亿元,估量内资公司IC 载板总营收15 亿元旁边(珠海越亚2013 年营收为3.5 亿元),占海内市场总规模不敷5%。比较于产值环球遥遥领先的PCB 家当,内资IC 载板行业具有极大的国产化空间。
海内晶圆厂扩产带来巨额增量空间,内资IC 载板龙头有望充分受益。在 国家意志的驱动下,我国半导系统编制造业开始飞速发展,大量晶圆厂正处于培植 阶段或者被方案培植阶段。截止2018 年末,我国拥有近50 条正在培植或准备 培植的晶圆产线,个中大部分为12 寸晶圆产线,少部分为8 寸产线和化合物 半导体产线,个中存储芯片厂更是重中之重。目前我国在建的存储芯片厂培植 方紧张有三个,分别长江存储、合肥长鑫和紫光集团,总操持产能为50+万平 米/月,估量内资存储厂扩产空间就将带来20 亿元以上的IC 载板增量空间, 如果将别的晶圆产线考虑在内,那么单单内资半导体市场的IC 载板需求就有 极大潜力可挖。
4.行业内重点标的先容:略
温馨提示:如需原文档,可在PC端上岸未来智库www.vzkoo.com搜索下载本报告。
(报告来源:东方财富证券;剖析师:卢嘉鹏)













