封装毛病与失落效的研究方法论
封装的失落效机理可以分为两类:过应力和磨损。

过应力失落效每每是瞬时的、灾害性的;磨丢失效是长期的累积破坏,每每首先表示为性能退化,接着才是器件失落效。失落效的负载类型又可以分为机器、热、电气、辐射和化学负载等。
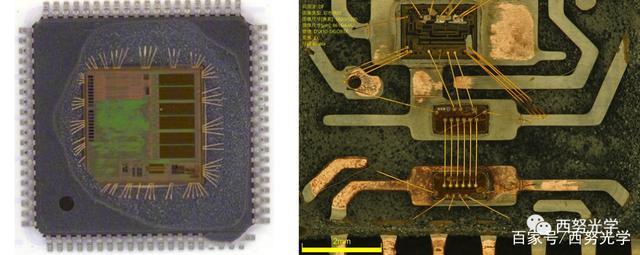
影响封装毛病和失落效的成分是多种多样的, 材料身分和属性、封装设计、环境条件和工艺参数等都会有所影响。确定影响成分是预防封装毛病和失落效的基本条件。
影响成分可以通过试验或者仿照仿真的方法来确定,一样平常多采取物理模型法和数值参数法。对付更繁芜的毛病和失落效机理,常常采取试差法确定关键的影响成分,但是这个方法须要较长的试验韶光和设备改动,效率低、花费高。
在剖析失落效机理的过程中, 采取鱼骨图(因果图)展示影响成分是行业通用的方法。鱼骨图可以解释繁芜的缘故原由及影响成分和封装毛病之间的关系,也可以区分多种缘故原由并将其分门别类。
生产运用中,有一类鱼骨图被称为6Ms:从机器、方法、材料、量度、人力和自然力等六个维度剖析影响成分。
这一张图所示的是展示塑封芯片分层缘故原由的鱼骨图,从设计、工艺、环境和材料四个方面进行了剖析。通过鱼骨图,清晰地展现了所有的影响成分,为失落效剖析奠定了良好根本。
引发失落效的负载类型
如上一节所述,封装的负载类型可以分为机器、热、电气、辐射和化学负载。
1、失落效机理的分类
机器载荷:包括物理冲击、振动、添补颗粒在硅芯片上施加的应力(如紧缩应力)和惯性力(如宇宙飞船的巨大加速度)等。材料对这些载荷的相应可能表现为弹性形变、塑性形变、翘曲、脆性或柔性断裂、界面分层、疲倦裂痕产生和扩展、蠕变以及蠕变开裂等等。
热载荷:包括芯片黏结剂固化时的高温、引线键合前的预加热、成型工艺、后固化、临近元器件的再加工、浸焊、气相焊接和回流焊接等等。外部热载荷会使材料因热膨胀而发生尺寸变革,同时也会改变蠕变速率等物理属性。如发生热膨胀系数失落配(CTE失落配)进而引发局部应力,并终极导致封装构造失落效。过大的热载荷乃至可能会导致器件内易燃材料发生燃烧。
电载荷:包括溘然的电冲击、电压不稳或电流传输时溘然的振荡(如接地不良)而引起的电流颠簸、静电放电、过电应力等。这些外部电载荷可能导致介质击穿、电压表面击穿、电能的热损耗或电迁移。也可能增加电解堕落、树枝状结晶成长,引起泄电流、热致退化等。
化学载荷:包括化学利用环境导致的堕落、氧化和离子表面枝晶成长。由于湿气能通过塑封料渗透,因此在湿润环境下湿气是影响塑封器件的紧张问题。
被塑封料接管的湿气能将塑封估中的催化剂残留萃取出来,形成副产物进入芯片粘接的金属底座、半导体材料和各种界面,诱发导致器件性能退化乃至失落效。
例如,组装后残留在器件上的助焊剂会通过塑封料迁移到芯片表面。在高频电路中,介质属性的细微变革(如吸潮后的介电常数、耗散因子等的变革)都非常关键。在高电压转换器等器件中,封装体击穿电压的变革非常关键。
此外,一些环氧聚酰胺和聚氨酯如若长期暴露在高温高湿环境中也会引起降解(有时也称为“逆转”)。常日采取加速试验来鉴定塑封料是否易发生该种失落效。
须要把稳的是,当施加不同类型载荷的时候,各种失落效机理可能同时在塑封器件上产生交互浸染。
例如,热载荷会使封装体构造内相邻材料间发生热膨胀系数失落配,从而引起机器失落效。其他的交互浸染,包括应力赞助堕落、应力堕落裂纹、场致金属迁移、钝化层和电解质层裂痕、湿热导致的封装体开裂以及温度导致的化学反应加速等等。在这些情形下,失落效机理的综合影响并不一定即是个体影响的总和。
封装毛病的分类
封装毛病紧张包括引线变形、底座偏移、翘曲、芯片分裂、分层、空洞、不屈均封装、毛边、外来颗粒和不完备固化等。
1、引线变形
引线变形常日指塑封料流动过程中引起的引线位移或者变形,常日采取引线最大横向位移x与引线长度L之间的比值x/L来表示。引线波折可能会导致电器短路(特殊是在高密度I/O器件封装中)。有时,波折产生的应力会导致键合点开裂或键合强度低落。
影响引线键合的成分包括封装设计、引线布局、引线材料与尺寸、模塑料属性、引线键合工艺和封装工艺等。影响引线波折的引线参数包括引线直径、引线长度、引线断裂载荷和引线密度等等。
2、底座偏移
底座偏移指的是支撑芯片的载体(芯片底座)涌现变形和偏移。
如图所示为塑封料导致的底座偏移,此时,高下层模塑腔体内不屈均的塑封料流动会导致底座偏移。
影响底座偏移的成分包括塑封料的流动性、引线框架的组装设计以及塑封料和引线框架的材料属性。薄型小尺寸封装(TSOP)和薄型方形扁平封装(TQFP)等封装器件由于引线框架较薄,随意马虎发生底座偏移和引脚变形。
3、翘曲
翘曲是指封装器件在平面外的波折和变形。因塑封工艺而引起的翘曲会导致如分层和芯片开裂等一系列的可靠性问题。 翘曲也会导致一系列的制造问题,如在塑封球栅阵列(PBGA)器件中,翘曲会导致焊料球共面性差,使器件在组装到印刷电路板的回流焊过程中发生贴装问题。
3、翘曲模式包括内凹、外凸和组合模式三种
导致翘曲的缘故原由紧张包括CTE失落配和固化/压缩紧缩。后者一开始并没有受到太多的关注,深入研究创造,模塑料的化学紧缩在IC器件的翘曲中也扮演着重要角色,尤其是在芯片高下两侧厚度不同的封装器件上。在固化和后固化的过程中,塑封料在高固化温度下将发生化学紧缩,被称为“热化学紧缩”。通过提高玻璃化转变温度和降落Tg附近的热膨胀系数变革,可以减小固化过程中发生的化学紧缩。
导致翘曲的成分还包括诸如塑封料身分、模塑料湿气、封装的几何构造等等。通过对塑封材料和身分、工艺参数、封装构造和封装前环境的把控,可以将封装翘曲降落到最小。在某些情形下,可以通过封装电子组件的背面来进行翘曲的补偿。例如,大陶瓷电路板或多层板的外部连接位于同一侧,对他们进行背面封装可以减小翘曲。
4、芯片分裂
封装工艺中产生的应力会导致芯片分裂。封装工艺常日会加重前道组装工艺中形成的微裂痕。晶圆或芯片减薄、背面研磨以及芯片粘结都是可能导致芯片裂痕萌生的步骤。
分裂的、机器失落效的芯片不一定会发生电气失落效。芯片分裂是否会导致器件的瞬间电气失落效还取决于裂痕的成长路径。例如,若裂痕涌如今芯片的背面,可能不会影响到任何敏感构造。
由于硅晶圆比较薄且脆,晶圆级封装更随意马虎发生芯片分裂。因此,必须严格掌握转移成型工艺中的夹持压力和成型转换压力等工艺参数,以防止芯片分裂。3D堆叠封装中因叠层工艺而随意马虎涌现芯片分裂。在3D封装中影响芯片分裂的设计成分包括芯片叠层构造、基板厚度、模塑体积和模套厚度等。
5、分层
分层或粘结不牢指的是在塑封料和其相邻材料界面之间的分离。分层位置可能发生在塑封微电子器件中的任何区域;同时也可能发生在封装工艺、后封装制造阶段或者器件利用阶段。
封装工艺导致的不良粘接界面是引起分层的紧张成分。界面空洞、封装时的表面污染和固化不完备都会导致粘接不良。其他影响成分还包括固化和冷却时紧缩应力与翘曲。在冷却过程中,塑封料和相邻材料之间的CTE不匹配也会导致热-机器应力,从而导致分层。
可以根据界面类型对分层进行分类
6、空洞
封装工艺中,气泡嵌入环氧材料中形成了空洞,空洞可以发生在封装工艺过程中的任意阶段,包括转移成型、添补、灌封和塑封料至于空气环境下的印刷。通过最小化空宇量,如排空或者抽真空,可以减少空洞。有宣布采取的真空压力范围为1~300Torr(一个大气压为760Torr)。
填模拟真剖析认为,是底部熔体前沿与芯片打仗,导致了流动性受到阻碍。部分熔体前沿向上流动并通过芯片外围的大开口区域添补半模顶部。新形成的熔体前沿和吸附的熔体前沿进入半模顶部区域,从而形成起泡。
7、不屈均封装
非均匀的塑封体厚度会导致翘曲和分层。传统的封装技能,诸如转移成型、压力成型和贯注封装技能等,不易产生厚度不屈均的封装毛病。晶圆级封装因其工艺特点,而特殊随意马虎导致不屈均的塑封厚度。
为了确保得到均匀的塑封层厚度,应固定晶圆载体使其倾斜度最小以便于刮刀安装。此外,须要进行刮刀位置掌握以确保刮刀压力稳定,从而得到均匀的塑封层厚度。
在硬化前,当添补粒子在塑封估中的局部区域聚拢并形成不屈均分布时,会导致不同质或不屈均的材料组成。塑封料的不充分稠浊将会导致封装灌封过程中不同质征象的发生。
8、毛边
毛边是指在塑封成型工艺中通过分型线并沉积在器件引脚上的模塑料。
夹持压力不敷是产生毛边的紧张缘故原由。如果引脚上的模料残留没有及时打消,将导致组装阶段产生各种问题。例如,不才一个封装阶段中键合或者黏附不充分。树脂泄露是较稀疏的毛边形式。
9、外来颗粒
在封装工艺中,封装材料若暴露在污染的环境、设备或者材料中,外来粒子就会在封装中扩散并聚拢在封装内的金属部位上(如IC芯片和引线键合点),从而导致堕落和其他的后续可靠性问题。
10、不完备固化
固化韶光不敷或者固化温度偏低都会导致不完备固化。其余,在两种封装料的贯注中,稠浊比例的轻微偏移都将导致不完备固化。为了最大化实现封装材料的特性,必须确保封装材料完备固化。在很多封装方法中,许可采取后固化的方法确保封装材料的完备固化。而且要把稳担保封装料比例的精确配比。
封装失落效的分类
在封装组装阶段或者器件利用阶段,都会发生封装失落效。特殊是当封装微电子器件组装到印刷电路板上时更随意马虎发生,该阶段器件须要承受高的回流温度,会导致塑封料界面分层或者分裂。
1、分层
如上一节所述,分层是指塑封材料在粘接界面处与相邻的材料分离。可能导致分层的外部载荷和应力包括水汽、湿气、温度以及它们的共同浸染。
在组装阶段常常发生的一类分层被称为水汽勾引(或蒸汽勾引)分层,其失落效机理紧张是相对高温下的水汽压力。
在封装器件被组装到印刷电路板上的时候,为使焊料融化温度须要达到220℃乃至更高,这远高于模塑料的玻璃化转变温度(约110~200℃)。
在回流高温下,塑封料与金属界面之间存在的水汽蒸发形成水蒸气,产生的蒸汽压与材料间热失落配、吸湿膨胀引起的应力等成分共同浸染,终极导致界面粘接不牢或分层,乃至导致封装体的分裂。
无铅焊料比较传统铅基焊料,其回流温度更高,更随意马虎发生分层问题。
2、吸湿膨胀系数(CHE),又称湿气膨胀系数(CME)
湿气扩散到封装界面的失落效机理是水汽和湿气引起分层的主要成分。
湿气可通过封装体扩散,或者沿着引线框架和模塑料的界面扩散。研究创造,当模塑料和引线框架界面之间具有良好粘接时,湿气紧张通过塑封体进入封装内部。
但是,当这个粘结界面因封装工艺不良(如键合温度引起的氧化、应力开释不充分引起的引线框架翘曲或者过度修剪和形式应力等)而退化时,在封装轮廓上会形身分层和微裂痕,并且湿气或者水汽将易于沿这一起径扩散。
更糟糕的是,湿气会导致极性环氧黏结剂的水合浸染,从而弱化和降落界面的化学键合。
表面清洁是实现良好粘结的关键哀求。表面氧化常常导致分层的发生(如上一篇中所提到的例子),如铜合金引线框架暴露在高温下就常常导致分层。氮气或其他合成气体的存在,有利于避免氧化。
模塑估中的润滑剂和附着力促进剂会促进分层。润滑剂可以帮助模塑料与模具型腔分离,但会增加界面分层的风险。另一方面,附着力促进剂可以确保模塑料和芯片界面之间的良好粘结,但却难以从模具型腔内打消。
分层不仅为水汽扩散供应了路径,也是树脂裂痕的源头。分层界面是裂痕萌生的位置,当承受交大外部载荷的时候,裂痕会通过树脂扩展。
研究表明,发生在芯片底座地面和树脂之间的分层最随意马虎引起树脂裂痕,其它位置涌现的界面分层对树脂裂痕的影响较小。
3、气相勾引裂痕(爆米花征象)
水汽勾引分层进一步发展会导致气相勾引裂痕。当封装体内水汽通过裂痕逃逸时会产生爆裂声,和爆米花的声音非常像,因此又被称为爆米花征象。
裂痕常常从芯片底座向塑封底面扩展。在焊接后的电路板中,外不雅观检讨难以创造这些裂痕。QFP和TQFP等大而薄的塑封形式最随意马虎产生爆米花征象;此外也随意马虎发生在芯片底座面积与器件面积之比较大、芯片底座面积与最小塑封料厚度之比较大的的器件中。
爆米花征象可能会伴随其他问题,包括键合球从键合盘上断裂以及键合球下面的硅凹坑等。
塑封器件内的裂痕常日起源于引线框架上的应力集中区(如边缘和毛边),并且在最薄塑封区域内扩展。毛边是引线框架表面在冲压工艺中产生的小尺寸变形,改变冲压方向使毛边位于引线框架顶部,或者刻蚀引线框架(模压)都可以减少裂痕。
减少塑封器件内的湿气是降落爆米花征象的关键。常采取高温烘烤的方法减少塑封器件内的湿气。古人研究创造,封装内许可的安全湿气含量约为1100×10^-6(0.11 wt.%)。在125℃下烘烤24h,可以充分去除封装内接管的湿气。
4、脆性断裂
脆性断裂常常发生在低屈从强度和非弹性材料中(如硅芯片)。到材料受到过应力浸染时,溘然的、灾害性的裂痕扩展会起源于如空洞、夹杂物或不连续等眇小毛病。
5、韧性断裂
塑封材料随意马虎发生脆性和韧性两种断裂模式,紧张取决于环境和材料成分,包括温度、聚合树脂的黏塑特性和添补载荷。
纵然在含有脆性硅填料的高加载塑封材料中,因聚合树脂的黏塑特性,仍旧可能发生韧性断裂。
6、疲倦断裂
塑封料遭受到极限强度范围内的周期性应力浸染时,会因累积的疲倦断裂而断裂。
施加到塑封材料上的湿、热、机器或综合载荷,都会产生循环应力。疲倦失落效是一种磨丢失效机理,裂痕一样平常会在间断点或毛病位置萌生。
疲倦断裂机理包括三个阶段:裂纹萌生(阶段Ⅰ);稳定的裂痕扩展(阶段Ⅱ);突发的、不愿定的、灾害性失落效(阶段Ⅲ)。在周期性应力下,阶段Ⅱ的疲倦裂痕扩展指的是裂痕长度的稳定增长。塑封材料的裂纹扩展速率要远高于金属材料疲倦裂痕扩展的范例值(约3倍)。
7、加速失落效的成分
环境和材料的载荷和应力,如湿气、温度和污染物,会加速塑封器件的失落效。
塑封工艺正在封装失落效中起到了关键浸染,如湿气扩散系数、饱和湿气含量、离子扩散速率、热膨胀系数和塑封材料的吸湿膨胀系数等特性会极大地影响失落效速率。
导致失落效加速的成分紧张有潮气、温度、污染物和溶剂性环境、残余应力、自然环境应力、制造和组装载荷以及综合载荷应力条件。
潮气 能加速塑封微电子器件的分层、裂痕和堕落失落效。在塑封器件中, 潮气是一个主要的失落效加速因子。
与潮气导致失落效加速有关的机理包括粘结面退化、吸湿膨胀应力、水汽压力、离子迁移以及塑封料特性改变等等。潮气能够改变塑封料的玻璃化转变温度Tg、弹性模量和体积电阻率等特性。
温度 是另一个关键的失落效加速因子,常日利用与模塑料的玻璃化转变温度、各种材料的热膨胀洗漱以及由此引起的热-机器应力干系的温度等级来评估温度对封装失落效的影响。
温度对封装失落效的另一个影响成分表现在会改变与温度干系的封装材料属性、湿气扩散系数和金属间扩散等失落效。
污染物和溶剂性环境 污染物为失落效的萌生和扩展供应了场所,污染源紧张有大气污染物、湿气、助焊剂残留、塑封估中的不清洁例子、热退化产生的堕落性元素以及芯片黏结剂中排出的副产物(常日为环氧)。
塑料封装体一样平常不会被堕落,但是湿气和污染物会在塑封估中扩散并达到金属部位,引起塑封器件内金属部分的堕落。
残余应力 芯片粘结会产生单于应力。应力水平的大小,紧张取决于芯片粘接层的特性。由于模塑料的紧缩大于其他封装材料, 因此模塑成型时产生的应力是相称大的。可以采取应力测试芯片来测定组装应力。
自然环境应力 在自然环境下,塑封料可能会发生降解。降解的特点是聚合键的断裂,常常是固体聚合物转变成包含单体、二聚体和其他低分子量种类的黏性液体。
升高的温度和密闭的环境常常会加速降解。阳光中的紫外线和大气臭氧层是降解的强有力催化剂,可通过割断环氧树脂的分子链导致降解。
将塑封器件与易诱发降解的环境隔离、采取具有抗降解能力的聚合物都是防止降解的方法。须要在湿热心况下事情的产品哀求采取抗降解聚合物。
制造和组装载荷 制造和组装条件都有可能导致封装失落效,包括高温、低温、温度变革、操作载荷以及因塑封料流动而在键合引线和芯片底座上施加的载荷。进行塑封器件组装时涌现的爆米花征象便是一个范例的例子。
综合载荷应力条件 在制造、组装或者操作的过程中,诸如温度和湿气等失落效加速因子常常是同时存在的。综合载荷和应力条件常常会进一步加速失落效。这一特点常被运用于以毛病部件筛选和易失落效封装器件鉴别为目的的加速试验设计。
EDA365是30余万电子工程师相信的技能互换提升平台,我们不仅有可爱的阿杜、阿毛老师,神秘的John大神,还有超过50位版主,个中不乏天下500强企业的首席专家,涉及硬件设计、芯片封装、射频微波、电磁兼容、PCB设计、SI&PI、制造工艺、研发管理等多个领域。您可以在EDA365对应栏目进行学习,有自己办理不了的问题亦可发帖讯问,除了行业大神,还有EDA365特邀大咖版主为您“排忧解惑”。【如果你喜好EDA365的文章,记得关注和点赞哦!】












