据ZDNet宣布,JEDEC固态存储协会可能会放宽HBM4在高度方面的哀求,也便是最高的720微米的限定。为了降落三星、SK海力士和美光的制造难度,传闻JEDEC可能将12层及16层堆叠的HBM4高度放宽至775微米,这意味着存储器制造商可以在现有的键合技能中实现16层堆叠,无需转向新的稠浊键合技能。
目前无论是三星的TC NCF技能还是SK海力士的MR-RUF技能,都是利用凸块实现层与层之间的连接。上个月三星宣告,已开拓出业界首款HBM3E 12H DRAM,从过去的8层堆叠提高至12层堆叠,而且通过对TC NCF材料的优化,已经将间隙减低至7微米。不过要实现16层堆叠,厚度一定会连续增加,现有的技能在原限定高度下很难实现这样的操作。

稠浊键合技能不须要凸块,通过板载芯片和晶圆直接键合,让层与层之间更加紧密,以减少封装厚度。不过稠浊键合技能尚未成熟,而且比较现有的键合技能过于昂贵,因此现阶段存储器制造商还不太乐意采取。
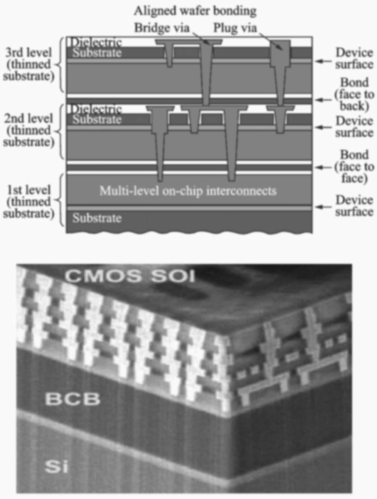
随着JEDEC赞许放宽HBM4的高度限定哀求,一方面为稠浊键合技能争取到了更多的开拓韶光,另一方面也加快了HBM4的商业化进程。














