头部企业纷纭入局
近一年来,封测领域头部企业纷纭透露出布局玻璃基板的。

2023年9月,英特尔宣告将在2030年前推出用于下一代前辈封装的玻璃基板。并称包括玻璃基板在内的前辈封装技能,将有助于英特尔实现2030年在单个封装上集成一万亿个晶体管的目标。
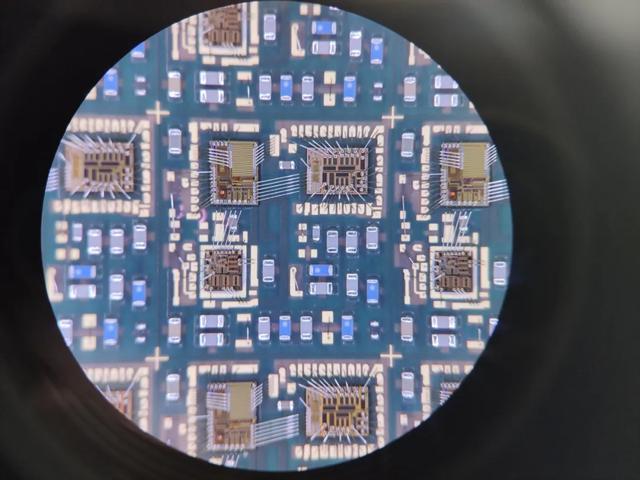
英特尔称,与目前采取的有机基板比较,玻璃具有超低平面度(flatness)、更好的热稳定性和机器稳定性,由于这些独特的性能,玻璃基板上的互连密度有望提升10倍。这意味着,采取该技能将支持在封装中连接更多晶体管,并支持以更小的尺寸封装更多的芯粒模块,构建更大的芯片组(即“系统级封装”)。
英特尔公司高等副总裁兼组装与测试技能开拓总经理Babak Sabi 称,英特尔已经对玻璃基板技能进行了十余年的研究。据理解,英特尔已在其位于亚利桑那州钱德勒的工厂投资了超过10亿美元,用于玻璃研发生产线,并开拓了具有3个再分配层(RDL)和75μm玻璃通孔(TGV)的电子功能组装多芯片封装(MCP)测试车。
近日,有称英特尔玻璃基板量产操持提前至2026年。对此,联系了英特尔干系卖力人,并得到回答称:最近没有更新的进展。
2024年1月,三星电机在 CES 2024 上宣告进军半导体玻璃基板领域,并公布了 2024 年建立中试线、2025 年量产样品、2026 年正式量产的路线图。根据方案,三星电机将在今年9月份之前将所需设备安装到试验线上,并在第四季度开始运营其试点生产线,比最初的操持提前了一个季度。
海内封测头部企业也在投资者平台针对本公司在玻璃基板领域的布局作出了回应:
华天科技表示,公司有玻璃基板封装研发布局。
通富微电表示,公司具有玻璃基板封装干系技能储备,具备利用TGV玻璃基板进行封装的技能能力。谢鸿在接管《中国电子报》采访时表示,通富微电玻璃基板技能大概在2026—2027年可以看到产品运用。
通富微电投资者平台问答
晶方科技表示,公司专注于传感器领域晶圆级封装技能做事。TSV、TGV等是晶圆级封装电互连的紧张技能工艺手段。结合传感器需求及自身工艺积累,公司具有多样化的玻璃加工技能,包括制作微构造,光学构造,镀膜,通孔,盲孔等,且公司自主开拓的玻璃基板,在Fanout等封装工艺上已有多年量产履历。
头部企业纷纭入局,彷佛预示着芯片封装企业真要的要迎来一场材料革命了?
此玻璃非彼玻璃
实际上,在芯片封装领域,玻璃已经在发挥浸染。例如为了实现对芯片的保护,家当界采纳了GPP(玻璃钝化)工艺技能,即将玻璃粉在晶圆表面烧结熔化后冷却,产生与芯片融为一体的玻璃层,从而起到保护的浸染。又如在晶圆封装领域,玻璃基板可用于在晶圆减薄之后的载片环节,即作为芯片的支撑基板,用以帮助芯片顺利完成后续加工环节,防止外部应力造成的碎片。上述案例,均已运用多年,即为业内所说的成熟工艺。
而近期被广为谈论的玻璃基板,与上述成熟工艺不同,指的是一种正在研发的新技能,即由玻璃替代当前的封装基板(IC Package Substrate)材料——ABF和BT树脂——IC载板最常用的两种材料。
个中,BT树脂载板在上世纪80年代实现初步运用,因BT树脂具备耐热性、抗湿性,低介电常数、低散失落成分等多种优秀特性,常用于稳定尺寸,防止热胀冷缩改进设备良率,紧张运用于存储芯片、MEMS芯片、RF芯片与 LED芯片中。近两三年景为在世界上迅速兴起的高密度互连(HDI)的积层多层板(BUM)、封装用基板的主要基板材料之一。
而另一种基板材料——ABF,在1999年之后逐渐成为半导体芯片行业的标配。该材料可用做线路较细、适宜高脚数高传输的IC,但材料易受热胀冷缩影响,可靠性较低,紧张用于CPU、GPU、FPGA、ASIC 等高性能打算(HPC)芯片FC封装。这两类基板材料凭借各自上风成为芯片封装基板的标配。
近期,之以是封装企业加码玻璃基板,源自市场对异构芯片需求的强烈增长。玻璃基板在吸引到越来越多的关注的同时,正在向替代当前封装基板材料的统治地位发起冲击。随着芯片处理需求的不断增长,Chiplet等异构封装需求愈来愈盛,这意味着单颗芯片的基板尺寸越来越大,而随着芯片基板的增大,直接面临的便是翘曲问题。
通富微电工程中央总经理谢鸿在接管《中国电子报》采访时表示:“目前广泛利用的有机基板和芯片的热膨胀差别较大。导致封装的翘曲问题。”
而玻璃即二氧化硅材料与硅基之间的热膨胀系数更为靠近,于是更易于避免芯片封装中可能涌现的翘曲问题。
这也正是英特尔此前在发布的公开信息中所说的“玻璃基板能使单个封装中的芯片面积增加五成,从而塞进更多的Chiplet”最紧张的缘故原由。
易碎是核心痛点
英特尔作为玻璃基板技能的先锋入局者,自十余年前已开始布局。而根据该公司自行公布的数据,估量将于2030年之前量产。作为Chiplet技能的紧张倡议与贡献者之一的英特尔,为何迟迟没有实现玻璃基板技能量产?
其紧张缘故原由在于玻璃基板的易碎性带来的潜在问题仍未彻底办理。首先,玻璃基板在生产过程中随意马虎断裂,不能像当前采取的有机基板一样钻孔;其次,采取玻璃基板封装的芯片的动态表现也较差。为理解释这一材料毛病,谢鸿向举了个例子:“比如我们用玻璃基板来封装手机芯片,那么采取该芯片的手机即便是从1米旁边的高度掉下来,都有可能导致芯片受损。”
英特尔玻璃基板测试单元
Yole Group 半导体封装技能与市场剖析师比拉尔·哈希米表示,玻璃的易碎性给设备内部处理和加工带来了问题,因此在制造过程中须要非常小心和精确。这对设备供应商和基板制造商来说是一个昂贵的寻衅。此外,玻璃基板给检讨和计量过程带来了繁芜性,须要专门的设备和技能来确保质量和可靠性。
如何办理玻璃易碎性的问题,成为困扰一众布局玻璃基板技能的企业共同关心的话题。
对此,谢鸿先容了当前业界办理这一问题的两大办理方案:
其一,从材料本身动手,即对玻璃材料本身进行处理,通过添加微量元素的办法,改变玻璃的机器性能;或是通过改变玻璃的制造过程,改变材料性能。
其二,开拓新的设备工艺。即通过借用其他材料或是变动产品生产工艺,实现保护的效果。
将率先替代大尺寸基板
关于芯片封装用玻璃基板的量产韶光,当前业内的普遍预估是在2026—2030年之间。集邦咨询剖析师许家源在接管《中国电子报》采访时表示,玻璃基板技能估量在2027—2028年量产。
而关于玻璃基板率先采取的运用处景,业界普遍认为将在对打算性能哀求较高的场景率先运用。
许家源认为,玻璃基板技能估量率先运用在做事器或条记本的处理器芯片。
英特尔表示,玻璃基板最先将被用于其更能发挥上风的地方,即须要更大尺寸封装和更快打算速率的运用和事情负载,包括数据中央、AI、图形打算等。
谢鸿表示,最先运用玻璃基板技能的场景,将是在60毫米以上的较大尺寸基板领域以及多芯片异构集成的产品中,此类产品多为高性能产品。
对付当前打算需求提升带给前辈封装的哀求,玻璃基板也将成为有力“小帮手”。一如当前前辈封装常常采取的2.5D、3D封装的方法,将扩大封装基板的利用面积。若采取当前市情上的传统有机材料基板,更大的封装基板面积意味着更大的翘曲概率,而玻璃基板将大大降落翘曲的可能性。











